|
ある偏りの状態にある光をサンプルにたいし斜めに当てると、反射光の偏りの状態は変化します。
基板の上に平行な薄膜が生成されているサンプルの場合、偏光状態の変化は基板の屈折率と薄膜の膜厚と屈折率によって決まり、入射角と光源の波長をパラメーターとして古典的なFresnelの式によって計算することができます。この原理による装置は偏光解析装置と呼ばれています。
偏光解析装置は、誘電体薄膜の膜厚を非接触、非破壊でÅの精度で測定できる唯一の方式です。
測定の1単位を構成する微視的構造の数(格子数など)をnとする時、物理量の平均値からの揺らぎは一般に1/√nに比例します。
よって、ナノエレクトロニクスのスケールファクターが1μm×200Åから100nm×10Åに変化するとしたとき、1単位の示量数(たとえば膜厚)の平均値からの揺らぎは√2000 = 44.7倍になります。
統計量である揺らぎにかんする信頼できるデータを得るためには、大量の測定点を必要とします。
また偏光解析装置においては、光の偏りの変化は膜厚や屈折率以外のファクター(歪、界面など)にも敏感であり、測定結果の解析はモデル設定に依存します。これらのファクターは一般に膜厚や屈折率の面内分布の揺らぎよりも高い周波数でサンプルに存在します。したがって測定点はこれらの揺らぎファクターよりも微細でなければならず、サンプリング定理によってサンプル面内の不規則性の1/2以下の細かい点で測定することが必要です。同時にまた多数の測定点を測定して照合しない限りリズナブルなモデルを設定することも出来ません。
その一方 波長λ、幅⊿yの光ビームを作るとき、そのビームの広がりとその中の伝播方向の均一性とは回折効果によって相反的となり、 ビームが光線の向きと直角方向にそれる程度θは θ>λ/⊿yです。
よってある限界幅以下の入射光のビーム径ではその中の光の伝播方向が一定であると仮定することは出来なくなります。
エリプソメータにおいては測定精度を保障するためには入射ビームの中で光の伝播方向が一定であることが必要で、通常1mm以下のビーム径の入射光を使用すると測定精度が低下します。 したがって入射光のビーム径を小さくすることによって微細な観察を行おうという1点測定方式のアプローチには限界があります。1点式エリプソメータは、微細な不規則性や構造がある極薄膜やデバイスにたいしては平均的な値しか測定できず、結果として精度が低下します。
ユーレカの2次元エリプソメータはビームの平行度が確保できるよう十分大きなビーム径の平行光線を入射光として使用します。そして反射光学系で、反射光を数10万から100万本以上の微細なビームに分割します。
HR4000Kは2μmの面内分解能でサンプルの3.5×2mmの1,400,000点 を1回で測定できます。
光学顕微鏡の解像度は光の波長によって制約され、均質な材料での0.1μm以下の凹凸を観測することはできません。2次元エリプソメータは、オングストローム(0.1nm)の精度で膜厚の2次元的分布を測定します。それと同時に屈折率の2次元的分布も小数点以下1/1000の精度で測定します。 こうして、ユーレカの2次元エリプソメータは、光学顕微鏡では均一に見えるサンプルの材質や厚みの定量的分布を、2次元画像として表現します。
測定データから導かれるフーリエ解析や自己相関関数はパターンの対称性を表現します。
ナノサイズの構造が集団を成しているとき、これら物理量のウエハー内及びウエハー間での対称性および対称性の破れの計測とその原因の究明は、それを形成した成膜技術を評価し、技術開発の目標が明らかになることを意味します。
ユーレカの2次元エリプソメータは微細測定、多点測定、高速測定が可能な装置で、HR4000Kは1点測定方式のエリプソメータ 1,400,000台に相当する性能を同時に1台で実現します。特に極薄膜のサンプルの測定に対してきわめて精度の高い測定が可能になりました。
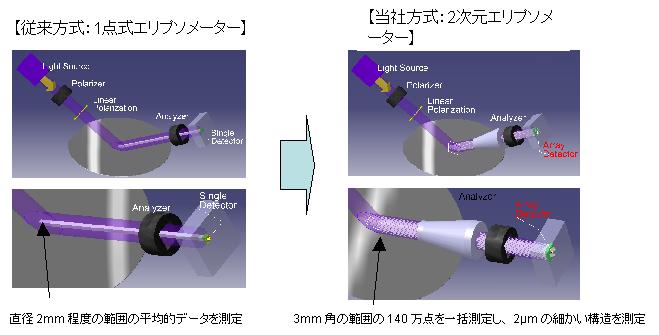
< |

