|

丂擬巁壔枌偺宍惉偑丄僂僄僴乕偺慹偝偵偳偺傛偆偵娭學偟偰偄傞偐傪抦傞偙偲偼嫽枴怺偄僥乕儅偱偁傞丅尋杹偟偨僔儕僐儞僂僄僴乕偺揟宆揑側慹偝偼俀nm慜屻(P-V)偱偁傞丅晄婯懃側慹偝偺廤崌偼偟偽偟偽僗僥僢僾丄僥儔僗側偳偲屇偽傟傞崅師峔憿傪宍惉偡傞丅偙傟傜偺僗働乕儖僼傽僋僞乕偼侾侽侽nm掱搙偱偁傞丅惉枌偼擬揑夁掱側偺偱僄儞僩儘僺乕傪憹戝偝偣丄傛偭偰偙傟傜偺崅師峔憿偼僾儘僙僗偺恑峴偵偮傟師戞偵尭彮偟偰偄偔偲峫偊傜傟傞丅
丂昞柺慹偝偼妋棪揑奣擮側偺偱丄柺慡懱傪俀師尦揑偵應掕偡傞昁梫偑偁傞丅廲曽岦偺惛搙偲偟偰偼丄僒僽nm偑昁梫偱偁傠偆丅偁偨偐傕愇峱宆偺墯撌偵傛偭偰尨宆偺墯撌傪抦傞傛偆偵丄巁壔枌偺枌岤暘晍傪抦傞偙偲偵傛偭偰丄巁壔枌偲僂僄僴乕偲偺奅柺偺崅師峔憿偵偮偄偰偺忣曬傪摼傞偙偲偑偱偒傞偐傕偟傟側偄丅偟偐偟俀師尦僄儕僾僜儊乕僞偺柺撪暘夝擻偼1側偄偟100兪倣偺僆乕僟乕偱丄昞柺偺宍懺偵懳偟偰偼旕忢偵慹偔丄應掕偺寢壥偼懡悢偺旝帇揑峔憿偵偮偄偰暯嬒壔偟偰偄傞偙偲偵側傞偺偱丄偦偙偐傜偳偺掱搙僨僼傿僯僢僩側忣曬偑摫偒弌偝傟傞偩傠偆偐丅柺撪暘夝擻偺侾扨埵偵偼偍傛偦100側偄偟10000偺旝帇揑峔憿偑娷傑傟傞丅僂僄僴乕慡懱傪應掕偡傞偙偲偼丄弶婜忦審偑彮偟偢偮堎側傞偙傟傜偺旝帇揑峔憿偺傾儞僒儞僽儖偵偨偄偡傞丄幚偺慹帇揑娤嶡傪峴偆偙偲偱偁傞丅1)偙偺傾儞僒儞僽儖偺暘晍偼僂僄僴乕屌桳偺摿惈傪偳偺傛偆偵偁傜傢偟偰偄傞偩傠偆偐丅
1) 偙偺偙偲偑尵偊傞偨傔偵偼丄1扨埵偵娷傑傟傞旝帇揑峔憿偺悢偵斾傋偰廫暘戝偒偄悢偺扨埵傪應掕偟側偗傟偽側傜側偄丅
丂傢傟傢傟偼堎側傞慹偝乮婎斅偺僂僄僴乕偺慹偝偼偦傟偧傟0.3丄0.5丄1.0nm俼俵俽乯傪帩偭偨僂僄僴乕忋偵25nm丄偍傛傃50nm傪憐掕偟偰偮偗偨巁壔枌傪2師尦僄儕僾僜儊乕僞俻俼侾俀侽俲乮柺撪暘夝擻300兪倣乯偵傛偭偰應掕偟偰傒偨丅埲壓偱偼25nm偺岤偝偺巁壔枌偵偮偄偰愢柧偡傞丅

恾1
枌岤25nm偺巁壔枌偺枌岤昞帵丅忋抜偼僂僄僴乕慡懱丄壓抜偼僒儞僾儖拞墰晹偺俁師尦昞帵丅婎斅偺慹偝偼嵍偐傜俼俵俽0.3丄0.5丄1.0nm
丂恾侾偼枌岤25nm偺巁壔枌偺枌岤昞帵偱忋抜偼僂僄僴乕慡懱丄壓抜偼丄僒儞僾儖拞墰晹偺俁師尦昞帵傪暲傋偨傕偺偱偁傞丅怓暘夝擻偼1僆儞僌僗僩儘乕儉偱偁傞丂(256怓昞帵)丅丂婎斅偺慹偝偼嵍偐傜俼俵俽0.3丄0.5丄1.0nm偱偁傞丅堦尒偟偰丄巁壔枌偺枌岤暘晍偺暯扲惈偼僂僄僴乕偺慹偝偵埶懚偡傞偙偲偑傢偐傞丅偦傟偼摉慠側偑傜惉枌偵偍偄偰僂僄僴乕偺昞柺慹偝偑廳梫側僼傽僋僞乕偱偁傞偙偲傪帵偟偰偄傞丅
丂偙偺応崌僒儞僾儖偵傛偭偰偼丄僄儕僾僜儊僩儕僀偺尨棟揑側慜採偱偁傞枌偲婎斅偲偺暯峴惈傗僒儞僾儖傊偺價乕儉偺堦條側擖幩側偳偺壖掕偑傕偼傗嬊強揑偵偼惉棫偟側偔側偭偰偔傞丅偦偟偰儈僋儘僗僐僺僢僋偵娤應偡傞偵偮傟孅愜棪傗枌岤偺應掕寢壥偵偼摿堎揰偑晄婯懃偵偁傜傢傟偰偔傞丅堦尒丄應掕寢壥偑晄埨掕偵尒偊傞偙傟傜偺摿堎揰偼僒儞僾儖偦偺傕偺偺晄婯懃惈傪乮掕惈揑偱偼偁傞偵偣傛乯昞偟偰偄傞偺偱偁傞丅2)
2) 廬棃偺侾揰幃偺僄儕僾僜儊乕僞偼丄扵恓偱偁傞岝價乕儉偺捈宎偑戝偒偄(栺1mm冇)偙偲偲丄應掕揰悢偑彮側偄偨傔偵丄偙偺晄婯懃惈傪娤應偱偒側偐偭偨丅敿摫懱婎斦媄弍尋媶夛丂UC昗弨壔埾堳夛丂嵽椏晹夛丗丂僂儖僩儔僋儕乕儞僥僋僲儘僕乕丂5(1993)[3] 51(237)

丂摑寁揑夝愅偺偨傔偵僂僄僴乕偺拞墰晹俀俆俇亊俀俆俇僺僋僙儖偺椞堟偺枌岤偺僗儁僋僩儖傪寁嶼偟偰傒偨丅恾俀偼偦偺椞堟慡懱偺丄恾俁偼1-3徾尷偺僗儁僋僩儖偱偁傞丅乮僌儔僼偺拞墰晹偑捈棳惉暘偲側傞岝妛昞帵乯丅乮埲壓偺恾偵偍偄偰偡傋偰丄僂僄僴乕偺慹偝偼嵍偐傜0.3丄0.5丄1.0nm俼俵俽乯丅恾2偺僗儁僋僩儖偺昗弨曃嵎偼嵍偐傜偦傟偧傟丄17.22丄19.18丄20.10偱偁傞丅僂僄僴乕偺慹偝偑憹偡偵偮傟崅廃攇惉暘偑戝偒偔側偭偰偄偔偺偑尒傜傟傞丅
恾俀丂
僂僄僴乕偺拞墰晹俀俆俇亊俀俆俇僺僋僙儖偺椞堟偺枌岤偺僗儁僋僩儖
丂丂丂丂丂

恾俁丂
僂僄僴乕偺拞墰晹俀俆俇亊俀俆俇僺僋僙儖偺椞堟偺枌岤偺1-3徾尷偺僗儁僋僩儖

恾係A丂
恾俀偺僗儁僋僩儖偐傜掅廃攇惉暘傪庢傝彍偄偨媡曄姺偵傛偭偰嵞惗偟偨枌岤丅

恾係B丂
恾俀偺僗儁僋僩儖偐傜崅廃攇惉暘傪庢傝彍偄偨媡曄姺偵傛偭偰嵞惗偟偨枌岤丅
慹帇壔偵傛偭偰幐傢傟偨忣曬偼戝検偺摑寁揑僨乕僞傪廤傔傞偙偲偵傛偭偰庢傝栠偡偙偲偑偱偒傞丅恾1偱尒偨傛偆偵丄枌岤偼婎斅偺宍忬場巕乮慹偝丄暯扲搙側偳乯偵傛偭偰塭嬁偝傟傞偺偱丄扨弮側枌岤暘晍偱偼側偔廃攇悢椞堟偺暘晍傪庢傞偙偲偑桳岠偱偁傞丅拲栚偡傞宍忬場巕偵憡摉偡傞廃攇悢斖埻傪僗儁僋僩儖偐傜愗傝弌偟偨僼乕儕僄媡曄姺偵傛偭偰枌岤傪嵞惗偡傞偙偲偼丄偟偽偟偽桳岠側暘愅庤朄偵側傞丅恾4俙偼掅廃攇惉暘傪庢傝彍偄偰枌岤傪嵞惗偟偨傕偺偱偁傝丄枌岤偺晄婯懃惈偑傛傝偼偭偒傝昞尰偝傟偰偄傞丅偄偭傐偆恾4俛偼崅廃攇惉暘傪庢傝彍偄偰枌岤傪嵞惗偟偨傕偺偱偁傞丅偍偺偍偺偑摨偠怓偱昞帵偝傟偰偄傞偙偲偐傜敾傞傛偆偵,婎斅偺慹偝偵埶懚偟側偄枌岤偺暯嬒抣傪應掕偡傞偙偲偑偱偒傞丅偙偺傛偆偵偟偰傕側偍巆傞晄婯懃惈偼擖幩妏偺堦條惈側偳偺彅慜採偑惉傝棫偨側偄堎忢側應掕揰偲夝庍偝傟傞丅
丂僗儁僋僩儖偺捈棳惉暘偼僾儘僙僗偵懳偟偰奜偐傜愝掕偝傟偨抣偱偁傞枌岤偺暯嬒抣偵憡摉偟丄崅廃攇惉暘偼僾儘僙僗偺弶婜忦審偲偟偰偺僂僄僴乕偺慹偝偵埶懚偡傞丅捠忢拲栚偝傟幚嵺揑偵偼傕偭傁傜應掕偝傟偰偒偨枌岤偺暯嬒抣偱偼側偔丄偦傟埲奜偺備傜偓惉暘偵偙偦僾儘僙僗偲僒儞僾儖偺屌桳偺摿惈偑娷傑傟偰偄傞偺偱偁傞丅
丂埲忋偺夝愅偲偼媡偵丄僗儁僋僩儖偺掅廃攇惉暘偼偳偺傛偆側場巕偵埶懚偟偰偄傞偩傠偆偐丅傎傏摨偠慹偝(RMS0.3nm)偺僂僄僴乕傪丄GF3R(Global Front 3Points Range)偲GBIR(Global Back-side Ideal Range)偲偑偦傟偧傟傎傏摨偠暯扲搙傪偁傜傢偡傛偆偵僌儖乕僾暘偗偟偰枌晅偗偟偰傒偨丅恾5偼25nm偺巁壔枌傪偮偗偨應掕抣偺戙昞揑側寢壥偱丄枌岤傪3師尦昞帵偟偨傕偺偱偁傞丅僂僄僴乕偺暯扲搙偺戙昞揑側抣偼嵍偐傜TTV偱1.0丄1.5丄2.0兪m偱偁傞丅恾6偼FFT偵傛傞枌岤偺僗儁僋僩儖傪昞帵偟偨傕偺偱偁傞丅偙偺応崌偼捈棳惉暘嬤朤偱偺僗儁僋僩儖偺宍傪拲栚偡傋偒偱丄暯扲搙偺埆偄僒儞僾儖傎偳捈棳惉暘嬤朤偑峀偄乮偡側傢偪俻偑彫偝偄乯傛偆偵尒偊傞丅恾7偼捈棳惉暘嬤朤偺傒巆偟偰僼乕儕僄媡曄姺傪峴偭偨寢壥偱偁傞丅
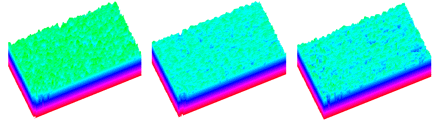
恾5丂
枌岤25nm偺巁壔枌丅僂僄僴乕偺慹偝偼RMS0.3nm暯扲搙偼嵍偐傜TTV偱1.0丄1.5丄2.0兪m

恾6丂
恾5偺應掕寢壥偺僗儁僋僩儖丅

恾7丂
恾俇偺僗儁僋僩儖偐傜捈棳惉暘嬤朤偺傒巆偟偨僼乕儕僄媡曄姺偵傛偭偰嵞惗偟偨枌岤
丂偙偺傛偆偵俀師尦僄儕僾僜儊乕僞偵傛傞枌岤應掕偺悢妛揑夝愅偼丄僂僄僴乕偺昞柺慹偝偺夝愅乮偦偟偰偦傟偑惉枌夁掱偱偳偺傛偆偵塭嬁偟偰偄偔偐乯偵偲偭偰嫽枴怺偄庤抜傪採嫙偡傞丅偦偙偱偼丄偳偺斖埻偺僗儁僋僩儖偵拲栚偟偰枌傪嵞惗偡傞偐偼夝愅幰偺敾抐偵備偩偹傜傟偰偄偰丄偦偺慖戰偵墳偠偰應掕寢壥偼堎側傞巔傪偁傜傢偡丅偙偺嶌嬈傪偮偆偠偰乮捠忢偺1揰幃偺應掕偱偼幪偰傜傟偰偄偨偺偱偁傞偑乯丄僾儘僙僗偲僒儞僾儖偵偐偐傢傞屌桳偺婱廳側忣曬傪媯傒弌偡偙偲偑偱偒傞丅
丂偙傟傜偺夝愅偺掕検揑側寢榑偼庡偵憰抲偺柺撪暘夝擻偵埶懚偟偰偄傞丅儐乕儗僇偼傛傝嵶偐偄柺撪暘夝擻傪傕偭偨憰抲傪奐敪拞偱偁傞偺偱丄偦傟偵傛偭偰偝傜偵偙偺僥乕儅傪捛媦偟偰偄偔梊掕偱偁傞丅
|